宽禁带半导体材料技术:InGaO三元氧化物
摘要:InGaO三元氧化物作为一种新型宽禁带半导体材料,通过镓掺杂显著提升了氧化铟的电子迁移率和稳定性。东京大学团队采用原子层沉积技术制备的InGaO基环绕栅极晶体管实现了44.5cm²/Vs的高电子迁移率。该材料制造涉及精密薄膜沉积、结晶化退火和GAA结构集成等关键工艺。质量控制需通过XRD、SEM等表征手段确保材料性能。尽管在工艺集成、可靠性等方面仍面临挑战,InGaO凭借其优异特性,有望成为

引言:InGaO三元氧化物体系一种备受瞩目的宽禁带半导体材料,尤其在新型微电子器件领域显示出了巨大的应用潜力。由于传统的硅基半导体正逐渐接近其物理极限,像InGaO(掺镓氧化铟)这类新型氧化物半导体材料,成为了延续摩尔定律、提升AI和大数据处理性能的重要候选者之一
一、nGaO材料的核心优势与特性
1. 核心优势
InGaO(掺镓氧化铟)作为一种新型的三元氧化物宽禁带半导体材料,其核心优势在于通过镓(Ga)掺杂优化了氧化铟(In₂O₃)的电学性能。氧化铟本身因其较高的电子迁移率而受到关注,但其固有的氧空位缺陷会导致载流子散射,影响器件的稳定性和可靠性。镓元素的引入,能有效抑制氧空位的形成,从而显著提升材料的稳定性和电子迁移率。
东京大学研究团队制备的基于InGaO的环绕栅极晶体管(GAAFET)实现了44.5 cm²/Vs的高电子迁移率,并且在高压应力测试下展现了出色的稳定性(连续稳定工作近三小时)。这种材料通常能形成高度有序的晶体结构,为电子提供了更高效的迁移路径,这对于提升器件性能至关重要。
2. 关键特性

InGaO材料关键特性概览
二、器件制造技术与工艺流程
InGaO器件的制造,特别是东京大学报道的“全环绕栅极”(GAA)MOSFET,结合了创新材料与先进结构设计。
1. 薄膜制备 - 原子层沉积(ALD)技术:
工艺原理:ALD通过逐层、自限制性的表面化学反应进行薄膜沉积,能实现原子级厚度控制和优异的三维共形性。这对于复杂三维结构(如GAA结构)的均匀涂层至关重要。
应用:研究团队使用ALD技术在沟道区域逐层涂覆InGaOx薄膜。前驱体通常选择铟、镓的有机金属化合物(如三甲基铟、三甲基镓)和氧气或水等氧源。
核心参数:前驱体脉冲时间、 purge时间、反应温度、循环次数(直接决定薄膜厚度)。
2. 后期热处理 - 结晶化退火:
目的:沉积得到的非晶或多晶InGaOx薄膜需要经过热处理才能转化为高度有序的晶体结构,这是获得高电子迁移率的关键步骤。
工艺条件:通常在较高温度(具体温度区间需根据前驱体和工艺确定) 的惰性气氛(如N₂)或适量O₂中进行。温度、时间、升温/冷却速率需要精确控制以实现理想晶化并防止元素偏析或缺陷。
3. 器件集成 - 全环绕栅极(GAA)结构:
结构优势:GAA结构使栅极完全包裹沟道,增强了栅极对沟道的控制能力,能有效抑制短沟道效应,并允许在更小尺寸下维持性能,提高了器件的可缩放性 (Scalability)。
制造挑战:纳米线或纳米片的精细加工、栅极介电层的均匀沉积、源漏区的形成以及接触孔填充等,都需要先进的刻蚀和薄膜工艺配合。
简化的核心工艺流程大致如下:
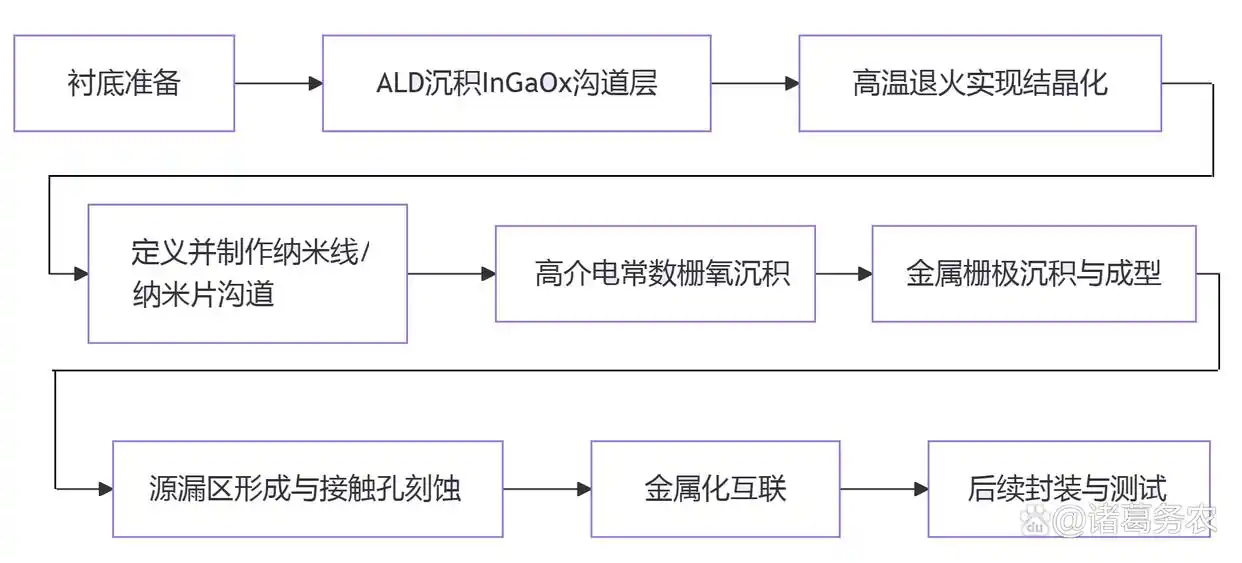
InGaO器件制造核心工艺流程
三、质量控制与性能检测
确保InGaO材料和器件的质量需要一套 rigorous 的检测与表征技术。
1. 成分与结构分析:
元素含量与杂质分析:可采用电感耦合等离子体质谱法(ICP-MS)(参考YS/T 742-2010标准)、X射线荧光光谱(XRF)等方法测定In、Ga比例并检测痕量杂质(要求往往≤50ppm)。
结晶性与晶体结构:高分辨X射线衍射(HR-XRD) 是分析晶体结构、取向、晶格参数和结晶度(通常要求≥95%)的强有力工具(参考相关测试方法标准)。东京大学团队成功制备了高度有序的InGaOx晶体。
表面与界面形貌:扫描电子显微镜(SEM) 和透射电子显微镜(TEM) 用于观察表面形貌、微观结构、界面质量和膜厚。原子力显微镜(AFM) 用于测量表面粗糙度(Ra值,要求通常≤0.5μm)。
2. 电学性能测试:
器件的电子迁移率、阈值电压、开关比、亚阈值摆幅等是关键参数。东京大学报道其器件迁移率达44.5 cm²/Vs。
电化学阻抗谱(EIS) 可用于评估材料的离子传输特性。
可靠性测试:如偏压温度应力测试(BTS) 用于评估器件在电应力和热应力下的稳定性。东京大学的器件在应力下稳定运行近3小时。
3. 其他性能表征:
热稳定性:通过热重-差示扫描量热法(TG-DSC) 分析材料的热分解温度、相变行为等(参考ISO 11358标准)。InGaO基器件需满足高温应用需求。
四、应用挑战与研究重点
尽管InGaO材料展现出巨大潜力,但其研究和应用仍面临诸多挑战和需要重点突破的方向:
-
理论与模拟:深入研究InGaO的电子能带结构、缺陷物理(尤其是 beyond 氧空位的其他缺陷)、载流子输运机制等基本物理性质,需要先进的第一性原理计算和蒙特卡罗模拟等理论工具支持。
-
材料生长与缺陷控制:如何在大面积衬底上实现高纯度、高均匀性、低缺陷密度(特别是界面态)的InGaO外延生长是关键。精确控制In/Ga比例及其在纵向和横向的分布也是一大难点。
-
工艺集成与兼容性:将InGaO器件与主流的CMOS工艺平台进行集成,面临 “后端兼容” 的挑战,例如低温工艺需求以避免对已有器件的损伤。
-
可靠性问题:需系统研究InGaO器件在长期工作应力下的退化机制,如偏压温度不稳定性(BTI)、热载流子注入(HCI)效应等,并寻找提升可靠性的途径。
-
P型掺杂的难题:与许多氧化物半导体一样,实现高性能、稳定的P型导电仍然是世界性难题,这限制了CMOS互补电路的实现,目前基于InGaO的器件多是N型。
五、总结
InGaO三元氧化物体系作为后硅时代颇具竞争力的候选材料,凭借其高迁移率、良好的稳定性以及与先进器件结构(如GAA)的兼容性,为延续摩尔定律、助力AI和大数据计算提供了新的技术路径。
目前该技术正处于从实验室研究向产业化前期过渡的关键阶段。未来的发展将依赖于材料生长技术的精进、缺陷的有效控制、与现有技术平台的集成方案突破,以及全面而严谨的标准评价体系的建立。虽然前路充满挑战,但InGaO所展现出的潜力令人期待,它有望在未来几年的高端芯片制造中扮演重要角色。
【免责声明】本文主要内容均源自公开信息和资料,部分内容引用了Ai,仅作参考,不作任何依据,责任自负。
更多推荐
 已为社区贡献64条内容
已为社区贡献64条内容









所有评论(0)