芯片FA分析
芯片FA是芯片故障分析的缩写。当芯片失效(如功能异常、参数漂移、短路、开路等)时,利用一系列先进的物理和化学技术手段,像“法医”一样,逐层解剖芯片,定位故障点,查明失效的根本原因(Root Cause),并确定其物理失效机理(Failure Mechanism)。目标不是简单地判断芯片“好”或“坏”,而是回答“为什么坏?和“怎么坏的?。最终目的是反馈给设计、制造、封装或应用环节,从而解决问题,提升
一、什么是芯片FA分析?
芯片FA 是 芯片故障分析 的缩写。它是一门涉及电子、物理、化学和材料科学的交叉学科,其核心任务是:
当芯片失效(如功能异常、参数漂移、短路、开路等)时,利用一系列先进的物理和化学技术手段,像“法医”一样,逐层解剖芯片,定位故障点,查明失效的根本原因(Root Cause),并确定其物理失效机理(Failure Mechanism)。
-
目标不是 简单地判断芯片“好”或“坏”,而是回答 “为什么坏?” 和 “怎么坏的?”。
-
最终目的 是反馈给设计、制造、封装或应用环节,从而解决问题,提升产品良率、可靠性和质量。
二、为什么需要进行FA分析?
FA是芯片产业中不可或缺的一环,其主要驱动力包括:
-
研发阶段:
-
新产品失效分析: 验证新设计、新工艺的可靠性,发现并修正设计缺陷或工艺弱点。
-
可靠性测试失败分析: 对HVS(高压应力)、HTOL(高温工作寿命)、EM(电迁移)等可靠性测试中失败的样品进行分析,评估产品寿命和失效模式。
-
-
生产制造阶段:
-
提升良率: 对在线测试或晶圆测试中失效的芯片进行分析,找出制造工艺中的问题(如光刻异常、刻蚀残留、薄膜缺陷等),是提升生产线良率的关键。
-
质量控制: 监控工艺稳定性,及时发现异常。
-
-
客户应用阶段:
-
客户退货分析: 分析客户在使用过程中失效的芯片,厘清责任(是芯片本身问题,还是应用不当?),并提供改进方案,维护客户关系。
-
现场失效分析: 对已在市场上出现问题的产品进行紧急分析,防止事态扩大。
-
-
竞争性分析和知识产权:
-
反向工程: 分析竞争对手的产品,了解其设计思路、工艺水平和技术特点。
-
专利侵权验证: 为知识产权诉讼提供证据。
-
三、FA分析的核心流程与“法则”
FA分析通常遵循一个标准的、非破坏性优先的流程,可以概括为以下步骤:
第一步:信息收集与非破坏性分析
这是FA成功的基础,旨在不破坏样品的前提下获取尽可能多的信息。
-
信息收集: 详细了解失效背景,包括芯片型号、批次、失效现象、测试条件、应用环境等。
-
电性验证:
-
使用精密测量仪器复现失效现象。
-
定位故障电路模块(如电源短路、某个IO失效、某个存储单元错误等)。
-
-
外观检查:
-
光学显微镜检查: 观察芯片封装表面是否有裂纹、烧毁、腐蚀、引脚损坏等。
-
X-Ray检查: 透视封装内部,检查引线键合、焊球、芯片贴装等是否存在异常(如键合线断裂、脱落、空洞)。
-
-
非接触式检测:
-
红外热成像: 快速定位芯片表面的热点(短路点通常会产生局部高温)。
-
发射显微镜: 利用光子发射定位缺陷,对于栅氧泄漏、PN结击穿、 latch-up等故障非常有效。
-
OBIRCH: 利用激光束扫描芯片,通过检测电阻变化引起的热效应,精确定位金属连线、通孔中的短路或高阻点。这是定位金属层缺陷的利器。
-
第二步:破坏性样品制备
当非破坏性分析无法定位到具体故障点时,需要进行破坏性分析。
-
开封:
-
湿法腐蚀: 使用强酸(如发烟硝酸)溶解塑料封装料。
-
等离子刻蚀: 用于更精确、更干净地去除封装料,特别是对敏感器件。
-
-
去层:
-
使用化学试剂或等离子体,从芯片最上层的钝化层开始,逐层去除金属互连层,暴露出下层金属或多晶硅、晶体管。
-
这个过程需要极高的精度和控制,以免损坏需要观察的结构。
-
第三步:精确定位与物理形貌分析
这是找到“犯罪现场”的关键一步。
-
SEM: 提供高分辨率、大景深的二次电子图像,用于观察缺陷的微观形貌(如金属线断裂、通孔缺失、形貌异常等)。
-
FIB: FA实验室的“超级工具”。
-
截面分析: 可以进行纳米级的精确定位切割,制备出缺陷的横截面样品,用于观察纵向结构(如接触孔底部的状况、栅氧厚度等)。
-
电路修改: 可以切断或连接金属线,用于功能调试或隔离故障。
-
透射电镜样品制备: 提取超薄样品,用于后续的TEM分析。
-
第四步:材料与结构分析
在找到缺陷点后,需要分析其成分和晶体结构,以确定失效机理。
-
EDS: 通常与SEM联用,通过分析特征X射线来定性、半定量地分析缺陷点的元素成分。(例如,分析腐蚀残留物、迁移金属的成分)。
-
TEM: 提供原子级分辨率,可以直观地观察栅氧层的晶格结构、界面状态、位错等,是分析超微细缺陷的终极手段。
-
其他技术: 如XPS(分析元素化学价态)、SIMS(分析极微量杂质)等,用于更深入的材料分析。
第五步:结论与报告
综合所有分析数据,给出最终结论:
-
失效现象: 芯片表现出什么故障?
-
失效位置: 故障的物理位置在哪里?(如Metal 3与Metal 4之间的Via短路)
-
失效机理: 物理上是什么原因导致的?(如电迁移导致金属线开路、FIB诱导的损伤、栅氧击穿等)
-
根本原因: 深层次的原因是什么?(如工艺配方不当、设计规则违反、材料污染、应用过应力等)
-
改进建议: 提出具体的纠正和预防措施。
四、常见的失效机理与对应FA手段
| 失效现象 | 可能失效机理 | 常用FA分析手段 |
|---|---|---|
| 电源短路 | 栅氧击穿、金属桥接、PN结损坏、封装内导电异物 | EMMI/OBIRCH定位 → 开封 → SEM观察 → FIB截面 |
| 信号开路 | 电迁移、应力空洞、通孔/接触孔不良、键合线断裂 | X-Ray → 开封 → 电子束探针 / FIB电路修改验证 |
| 参数漂移 | 界面态电荷、热载流子注入、离子污染、薄栅氧退化 | 电性分析定位 → EMMI → 去层 → FIB/TEM分析栅氧 |
| 功能失效 | 闩锁效应、软错误、设计缺陷、制程偏差导致时序问题 | EMMI定位异常发光点 → FIB截面分析 → 仿真验证 |
| 可靠性失效 | 电迁移、经时介质击穿、负偏压温度不稳定性 | 加速寿命测试后,采用与上述类似的流程进行定位和分析 |
总结
芯片FA分析是一个系统性的“侦探破案”过程,它结合了:
-
严谨的逻辑思维: 从现象到本质的推理。
-
先进的仪器平台: 从宏观到微观,从表面到内部的观察与分析能力。
-
深厚的专业知识: 对半导体物理、工艺、设计和材料的深刻理解。
更多推荐
 已为社区贡献1条内容
已为社区贡献1条内容

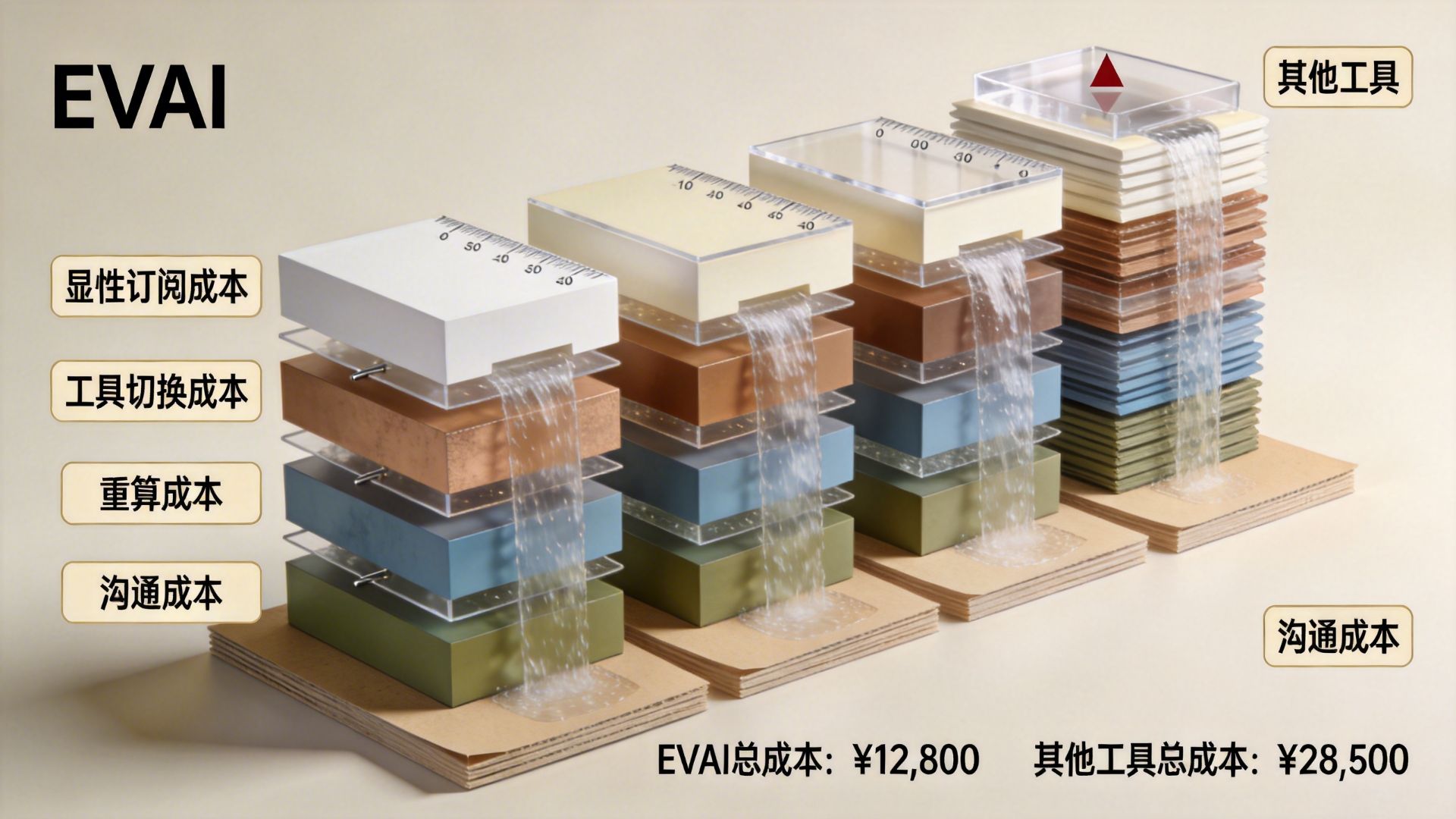






所有评论(0)