Data Center AI Chip Roadmap
全球科技巨头2025-2028年AI芯片竞争路线图曝光,包括NVIDIA、AMD、Intel等十余家企业的产品规划。路线图详细展示了各品牌芯片型号(如H200、TPUv5)、制造工艺(N3/N4P)、HBM内存规格(最高96GB)及封装技术(CoWoS系列)。通过季度色块直观呈现各芯片研发进度,NVIDIA、Google等企业布局最为长远。该图揭示了AI芯片向着更高性能、更低功耗的快速迭代趋势,反
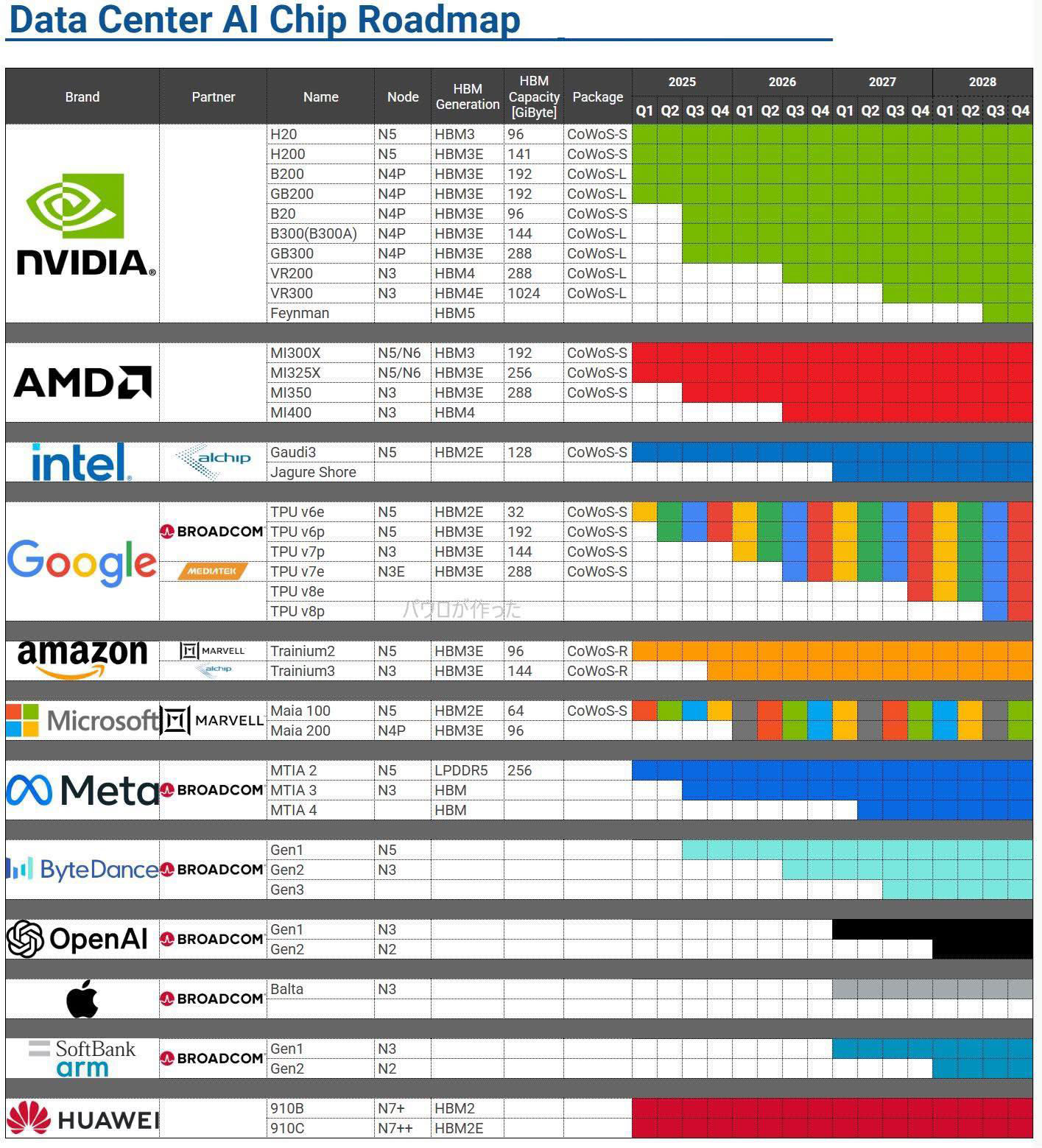
这张图是数据中心人工智能芯片路线图(Data Center AI Chip Roadmap),展示了不同品牌企业在 2025 - 2028 年期间,其数据中心 AI 芯片的相关规划与进展情况,涵盖多方面关键信息:
品牌与合作方(Brand & Partner)
罗列了 NVIDIA、AMD、Intel、Google、Amazon、Microsoft、Meta、ByteDance、OpenAI、Apple、SoftBank(旗下 arm)、HUAWEI 等知名科技企业,部分企业还有合作方,比如 Google 与 BROADCOM 等合作,Microsoft 与 MARVELL 合作等。
芯片名称(Name)
每个企业都有对应的芯片型号,像 NVIDIA 的 H200、B200,AMD 的 MI300X,Intel 的 Gaudi3,Google 的 TPU v5e、TPU v5p 等,不同型号芯片定位和性能有别。
工艺节点(Node)
代表芯片制造的工艺水平,如 NS(可能指特定节点规格)、N4P、N3 等,工艺节点越先进,通常芯片性能更强、功耗更低,比如 NVIDIA 的部分芯片采用 N4P、N3 工艺。
HBM(高带宽内存)相关
- HBM Generation:即 HBM 世代,如 HBM3、HBM3E、HBM4、HBM5 等,新一代 HBM 能提供更高带宽,满足 AI 芯片对数据高速传输的需求。
- HBM Capacity [GB]:HBM 内存容量,以 GB 为单位,像 NVIDIA 的 H200 HBM 容量为 96GB,随着型号升级,容量也有所提升,更大的容量有助于芯片处理大规模数据。
封装(Package)
如 CoWoS - S、CoWoS - L、CoWoS - R 等,不同封装技术影响芯片的集成度、散热等性能,适配不同应用场景需求。
时间与进展(2025 - 2028 各季度)
通过不同颜色的方块(绿色、红色、蓝色等),直观呈现各企业芯片在 2025 年 Q2 到 2028 年 Q4 期间,不同季度的发展或量产等进度情况,颜色方块覆盖的季度越多,说明该芯片在对应时间段内推进的周期越久或规划更长远。
整体而言,这张路线图清晰展现了全球主要科技企业在数据中心 AI 芯片领域的技术布局与发展节奏,反映出行业在 AI 芯片技术迭代、性能提升等方面的竞争与发展态势。
更多推荐
 已为社区贡献1条内容
已为社区贡献1条内容







所有评论(0)